De ce și cum să aplicăm tranzistoarele cu efect de câmp GaN pentru aplicații de putere în comutație eficiente, de tensiune mai mare
Contributed By DigiKey's North American Editors
2023-01-26
Eficiența energetică este o prioritate pentru sistemele electronice, având în vedere atât cerințele sociale, cât și cele de reglementare. În special, pentru aplicații care variază de la vehicule electrice (EV) la comunicații de înaltă tensiune și infrastructură industrială, eficiența conversiei de putere și densitatea de putere sunt esențiale pentru succesul proiectului.
Pentru a îndeplini aceste cerințe, proiectanții de sisteme de alimentare în comutație trebuie să renunțe la utilizarea tranzistoarelor cu efect de câmp cu oxid de metal (MOSFET) clasice pe bază de siliciu (Si) și a tranzistoarelor bipolare cu poartă izolată (IGBT), deoarece acestea se apropie rapid de limitele lor teoretice.
În schimb, proiectanții trebuie să ia în considerare dispozitive bazate pe materiale cu bandă interzisă largă (WBG), cum ar fi nitrura de galiu (GaN). Dispozitivele GaN comută mai rapid decât dispozitivele Si, suportă niveluri mai ridicate de tensiune și putere, sunt mult mai mici pentru un nivel de putere dat și funcționează mult mai eficient.
Acest articol va examina elementele de bază ale FET-urilor GaN, va arăta care sunt avantajele lor față de dispozitivele tradiționale Si în circuitele de putere în comutație, va prezenta exemple reale de la Nexperia și va discuta despre aplicarea lor.
Bazele FET-urilor GaN
Elementele fundamentale în circuitele de conversie a energiei sunt comutatoarele semiconductoare de înaltă tensiune. Proiectanții s-au concentrat pe îmbunătățirea performanțelor acestor dispozitive prin: reducerea pierderilor de conducție prin scăderea rezistenței în serie în starea de funcționare, reducerea pierderilor de comutare prin creșterea vitezelor de tranziție și reducerea efectelor parazite. În general, aceste eforturi de proiectare au avut succes în cazul MOSFET-urilor și IGBT-urilor din siliciu, dar rata de îmbunătățire a încetinit pe măsură ce funcționarea acestor dispozitive își atinge limitele teoretice.
Drept urmare, în ultimii ani au apărut dispozitive WBG care utilizează carbură de siliciu (SiC) și GaN, până în punctul în care au început să se producă în masă. Aceste dispozitive oferă intervale de tensiune de funcționare mai mari, timpi de comutare mai rapizi și eficiență îmbunătățită.
Banda interzisă a unui semiconductor reprezintă energia minimă necesară pentru excitarea electronilor în scopul de a-i elibera din starea lor legată într-o stare liberă, pentru a conduce electricitatea (Tabelul 1).
|
Tabelul 1: un rezumat al proprietăților cheie care diferențiază semiconductoarele cu bandă interzisă largă, cum ar fi GaN și SiC, de Si. (Sursa tabelului: Art Pini)
Dispozitivele realizate cu semiconductoare cu bandă interzisă largă pot funcționa la tensiuni, frecvențe și temperaturi mult mai mari decât materialele semiconductoare convenționale, cum ar fi Si. Banda interzisă mai largă este deosebit de importantă pentru a permite funcționarea dispozitivelor la temperaturi mult mai ridicate. Toleranța ridicată la temperatură înseamnă că, în condiții normale, aceste dispozitive pot funcționa la niveluri de putere mult mai ridicate. Semiconductoarele WBG cu un câmp electric critic mai mare și o mobilitate mai mare au cea mai mică rezistență drenă-sursă în stare pornită (RDS(ON)), ceea ce reduce pierderile de conducție.
Cele mai multe materiale cu bandă largă interzisă au, de asemenea, viteze ridicate ale electronilor liberi, ceea ce le permite să funcționeze la viteze de comutare mai mari.
În comparație cu Si, care are o bandă interzisă de 1,12 electroni-volți (eV), GaN și SiC sunt semiconductoare compuse cu benzi interzise de aproximativ trei ori mai mari, de 3,4 eV și, respectiv, 3,3 eV. Acest lucru înseamnă că ambele pot suporta tensiuni și frecvențe mai mari.
Mobilitatea mai mare a electronilor din GaN o face mult mai potrivită pentru aplicații de înaltă performanță și de înaltă frecvență. Vitezele de comutare mai rapide și frecvențele de operare mai mari permise de FET-urile de putere GaN rezultă într-un control îmbunătățit al semnalelor, proiecte de filtre pasive cu frecvențe de întrerupere mai mari și curenți de ondulație mai mici. Acest lucru permite utilizarea unor inductoare, condensatoare și transformatoare mai mici, ceea ce determină reducerea dimensiunii și greutății totale.
FET-urile GaN se numesc tranzistoare cu mobilitate ridicată a electronilor (HEMT). Mobilitatea ridicată a electronilor este o funcție a structurii FET (Figura 1).
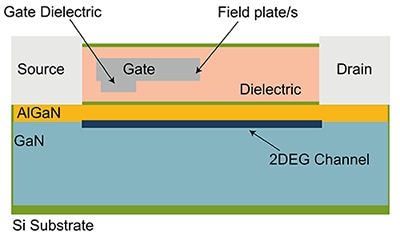 Figura 1: o vedere în secțiune transversală a unui FET GaN bazat pe un substrat de Si. (Sursa imaginii: Nexperia)
Figura 1: o vedere în secțiune transversală a unui FET GaN bazat pe un substrat de Si. (Sursa imaginii: Nexperia)
FET-urile GaN utilizează instalațiile de producție CMOS de siliciu existente, ceea ce le face rentabile. Un strat de GaN este format pe substratul Si prin depunerea unui strat-nucleu și a unui strat gradat de GaN și nitrură de aluminiu și galiu (AlGaN) ca strat de izolare (care nu este prezentat în diagramă), înainte ca stratul de GaN pur să crească. Un al doilea strat de AlGaN este depus deasupra stratului de GaN. Acest lucru stabilește o polarizare piezoelectrică, cu un exces de electroni generat imediat sub AlGaN, care este un canal foarte conductiv. Acest exces de electroni este cunoscut sub numele de gaz de electroni bidimensional (2DEG). Denumirea reflectă mobilitatea foarte mare a electronilor în acest strat.
Sub poartă se formează o regiune de epuizare. Funcționarea porții este similară cu cea a unui MOSFET de siliciu de putere cu canal N și mod de îmbunătățire. O tensiune pozitivă aplicată la poarta acestui dispozitiv îl activează.
Această structură se repetă de mai multe ori pentru a forma un dispozitiv de alimentare. Rezultatul final este o soluție fundamental simplă, elegantă și rentabilă pentru comutarea puterii.
Pentru a obține un dispozitiv de tensiune mai mare, distanța dintre drenă și poartă este mărită. Deoarece rezistivitatea GaN 2DEG este foarte scăzută, impactul asupra rezistenței prin creșterea capacității tensiunii de blocare este mult mai mic în comparație cu dispozitivele din siliciu.
FET-urile GaN pot fi construite pentru a funcționa în oricare dintre cele două configurații, în modul de îmbunătățire sau modul de epuizare. FET-urile cu mod de îmbunătățire sunt, în mod normal, oprite, astfel că o tensiune pozitivă în raport cu drena/sursa trebuie să fie aplicată la poartă pentru a porni FET-ul. FET-urile cu mod de epuizare sunt în mod normal active, astfel că trebuie aplicată o tensiune de poartă negativă în raport cu drena/sursa pentru a opri FET-ul. FET-urile cu mod de epuizare sunt problematice într-un sistem de alimentare, deoarece trebuie aplicată o polarizare negativă la FET-ul cu mod de epuizare GaN înainte de a alimenta sistemul.
O modalitate de a rezolva această problemă este de a combina un FET de siliciu de joasă tensiune cu un FET GaN cu mod de epuizare într-o configurație de circuit în montaj cascodă (Figura 2).
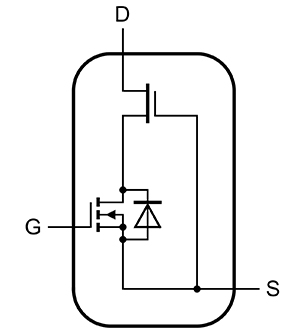 Figura 2: un MOSFET de siliciu de joasă tensiune într-o configurație cascodă cu un FET GaN cu mod de epuizare are ca rezultat robustețea structurii de poartă Si cu caracteristicile îmbunătățite de ceas de înaltă tensiune ale dispozitivului GaN, precum și faptul că, în cazul unui FET GaN cu mod de epuizare, dispozitivul compozit este oprit la pornire. (Sursă imagine: Nexperia)
Figura 2: un MOSFET de siliciu de joasă tensiune într-o configurație cascodă cu un FET GaN cu mod de epuizare are ca rezultat robustețea structurii de poartă Si cu caracteristicile îmbunătățite de ceas de înaltă tensiune ale dispozitivului GaN, precum și faptul că, în cazul unui FET GaN cu mod de epuizare, dispozitivul compozit este oprit la pornire. (Sursă imagine: Nexperia)
Circuitul în montaj cascodă utilizează structura de poartă MOSFET Si, care are avantajele unor limite mai mari de comandă a porții, adaptate la circuitele integrate de comandă a porții MOSFET existente, iar modul de epuizare FET GaN este oprit la pornire.
Una dintre caracteristicile cheie ale FET-urilor GaN este eficiența lor ridicată. Acest lucru se datorează: rezistenței reduse în serie, ce reduce pierderile de conducție; timpilor de comutare mai rapizi, ce reduc pierderile la comutare; și sarcinii mai mici cu recuperare inversă, care explică pierderile reduse de recuperare inversă.
Utilizând o topologie comună de convertor de amplificare cu jumătate de punte, este posibilă compararea eficiențelor FET-urilor GaN și a MOSFET-urilor Si (Figura 3).
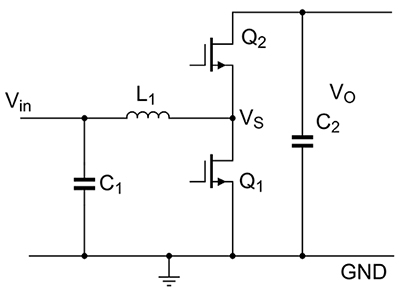 Figura 3: este prezentată schema unui convertor de amplificare cu jumătate de punte utilizat pentru compararea eficiențelor MOSFET-urilor și a FET-urilor GaN prin înlocuirea tranzistoarelor Q1 și Q2 cu fiecare tip. (Sursa imaginii: Nexperia)
Figura 3: este prezentată schema unui convertor de amplificare cu jumătate de punte utilizat pentru compararea eficiențelor MOSFET-urilor și a FET-urilor GaN prin înlocuirea tranzistoarelor Q1 și Q2 cu fiecare tip. (Sursa imaginii: Nexperia)
Convertorul de amplificare are o tensiune de intrare de 240 de volți, ieșirea este de 400 de volți, iar frecvența de comutare este de 100 kilohertzi (kHz). Eficiențele și pierderile sunt comparate pe o gamă de puteri de până la 3.500 wați (Figura 4).
 Figura 4: o comparație a eficienței și a pierderilor de putere între FET-urile GaN și MOSFET-uri într-un circuit identic, care arată avantajele FET-urilor GaN. (Sursă imagine: Nexperia)
Figura 4: o comparație a eficienței și a pierderilor de putere între FET-urile GaN și MOSFET-uri într-un circuit identic, care arată avantajele FET-urilor GaN. (Sursă imagine: Nexperia)
Eficiența FET-urilor GaN este cu aproximativ 20% mai mare în comparație cu cea a MOSFET-urilor, iar pierderea de putere este mai mică de aproximativ trei ori. La 2000 de wați, pierderea în MOSFET-uri este de aproximativ 62 de wați; în cazul FET-urilor GaN este de numai 19 wați. Acest lucru înseamnă că sistemul de răcire poate fi mai mic, îmbunătățind astfel eficiența volumetrică a convertorului de amplificare.
Mai puțin evident este faptul că măsurătorile au fost efectuate la aproape 3500 de wați pentru FET-ul GaN, datorită limitei maxime de tensiune mai mari a acestuia. Drept urmare, GaN FET are un avantaj clar.
Noțiuni introductive privind GaN pentru tensiuni mai mari
Pentru aplicații de tensiune mai mare, Nexperia oferă două FET-uri GaN de 650 de volți, GAN063-650WSAQ și GAN041-650WSBQ. Ambele sunt FET-uri cu canal N care sunt în mod normal oprite. GAN063-650WSAQ este evaluat pentru a suporta o tensiune maximă de la drenă la sursă de 650 de volți și poate susține o tensiune tranzitorie (cu o lățime a impulsului mai mică de o microsecundă) de 800 de volți. Acesta este evaluat pentru un curent de dren de 34,5 amperi (A) și o putere disipată de 143 wați la 25 °C. De obicei, rezistența în starea de pornire de la drenă la sursă este de 50 miliohmi (mΩ), cu o limită maximă de 60 mΩ.
GAN041-650WSBQ are aceeași tensiune nominală maximă de 650 de volți de la drenă la sursă, cu aceeași limită tranzitorie de 800 de volți. Acesta se deosebește prin faptul că poate suporta un curent de dren maxim de 47,2 A și o putere maximă de disipare de 187 wați la temperatura camerei. Rezistența tipică a canalului său este de 35 mΩ, cu un maxim de 41 mΩ.
În Figura 5 este prezentat un proiect de referință Nexperia care utilizează GAN063-650WSAQ într-o configurație cu jumătate de punte.
 Figura 5: proiectare recomandată pentru un etaj de putere cu jumătate de punte care utilizează FET-uri GaN GAN063-650WSA. Schema prezintă doar driverul FET și etajul de ieșire în jumătate de punte, precum și componentele aferente. (Sursa imaginii: Nexperia)
Figura 5: proiectare recomandată pentru un etaj de putere cu jumătate de punte care utilizează FET-uri GaN GAN063-650WSA. Schema prezintă doar driverul FET și etajul de ieșire în jumătate de punte, precum și componentele aferente. (Sursa imaginii: Nexperia)
Schema prezintă driverul de poartă dublu izolat high/low Si8230, care este utilizat pentru a comanda porțile FET-urilor GaN. Ieșirea driverului de poartă este conectată la poartă prin intermediul unui rezistor de poartă de 30 Ω, care este necesar pentru toate dispozitivele GaN. Rezistorul de poartă controlează timpul de încărcare a capacității de poartă, afectând performanța de comutare dinamică. În plus, rețelele R-C între drena și sursa FET-urilor ajută la controlul performanței de comutare. Nivelurile de comandă a porții pentru FET GaN sunt cuprinse între 0 și 10-12 volți.
Viteza mare de comutare a FET-urilor GaN (de obicei, în intervalul 10-11 nanosecunde (ns)) necesită o dispunere atentă pentru a minimiza inductanța parazită și utilizarea de amortizoare RC pentru a atenua oscilațiile pendulare datorate fenomenelor tranzitorii de tensiune și curent. În proiect există mai multe amortizoare RC (de la R17 până la 19 și de la C33 până la 35) între alimentarea de înaltă tensiune și masă. Amortizoarele reduc oscilațiile pendulare cauzate de interacțiunea dintre FET-ul GaN și rețeaua de bypass. Amortizoarele ar trebui să fie conectate cât mai aproape posibil de drena high-side a FET-ului. Acestea sunt implementate cu rezistoare montate pe suprafață și condensatoare ceramice cu rezistență efectivă în serie (ESR) redusă pentru a minimiza inductanța conductoarelor.
Rețeaua de componente formată din R4, D1, C12 și C13 este o sursă de alimentare bootstrap pentru driverul de poartă high-side. D1 ar trebui să fie o diodă rapidă, cu capacitate redusă, deoarece capacitatea sa de joncțiune contribuie la pierderea la comutare. R4 limitează curentul de încărcare la anclanșare; o valoare cuprinsă între 10 și 15 Ω funcționează bine.
Concluzie
De la vehiculele electrice la comunicațiile și infrastructura industrială, nevoia unei eficiențe sporite a conversiei și unei densități mai mari de putere necesită o schimbare față de structurile clasice de Si. După cum s-a arătat, FET-urile GaN oferă o modalitate de a avansa pentru proiectele din următoarea generație, oferind tensiuni de operare mai mari, timpi de comutare mai rapizi și eficiență îmbunătățită. Componentele din comerț, susținute în unele cazuri de proiecte de referință, îi ajută pe proiectanți să pună rapid proiectele în funcțiune.

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.