Cum să reduceți pierderile, să îmbunătățiți eficiența și să extindeți gama de temperaturi în aplicațiile de mare putere
Contributed By DigiKey's North American Editors
2023-09-08
Proiectanții de aplicații cu consum mare de energie au nevoie de convertoare de putere mai mici, mai ușoare și mai eficiente, capabile să funcționeze la tensiuni și temperaturi mai ridicate. Acest lucru este valabil în special în aplicații precum vehiculele electrice (EV), unde astfel de îmbunătățiri se traduc printr-o încărcare mai rapidă și o autonomie mai mare. Pentru a obține aceste îmbunătățiri, proiectanții folosesc convertoare de putere bazate pe tehnologii cu bandă interzisă largă (WBG), cum ar fi carbura de siliciu (SiC).
În comparație cu siliciul (Si), aceste dispozitive funcționează la tensiuni mai mari și cântăresc mai puțin, dar au capacități similare de gestionare a energiei. De asemenea, funcționează la temperaturi mai ridicate, reducând nevoile de răcire a sistemului. Dispozitivele SiC pot funcționa la o frecvență de comutare mai mare, permițând utilizarea unor componente pasive mai mici care reduc dimensiunea și greutatea convertorului. Cu toate acestea, SiC este în continuă dezvoltare, eforturile mai recente având ca rezultat o rezistență mai mică în stare activă, reducând și mai mult pierderile de energie.
Acest articol discută pe scurt avantajele SiC față de Si, folosind vehiculele electrice pentru context. Apoi, discută despre evoluțiile SiC înainte de a prezenta cea de-a patra generație de MOSFET-uri SiC de la ROHM Semiconductor și de a ilustra modul în care acestea îi ajută pe proiectanți să reducă pierderile de putere, costurile și amprenta la sol
De ce să folosiți SiC?
Vehiculele electrice au nevoie de o capacitate mai mare a bateriei pentru o autonomie mai mare. În paralel cu această tendință, tensiunea bateriilor este crescută la 800 de volți pentru a reduce timpul de încărcare. Prin urmare, proiectanții de vehicule electrice au nevoie de dispozitive care pot rezista la aceste tensiuni mai mari și, în același timp, care pot reduce pierderile electrice și greutatea. A patra generație de MOSFET-uri SiC de la ROHM Semiconductor oferă pierderi mai mici prin toleranță mai mare la tensiune, pierderi de conducție și de comutare mai mici, precum și dimensiuni mai mici.
SiC, un semiconductor WBG, oferă o eficiență excepțională în aplicațiile de comutare a puterii de înaltă tensiune în comparație cu tehnologia MOSFET Si. O comparație a proprietăților fizice ale SiC și Si arată sursa acestei îmbunătățiri pe baza a cinci proprietăți fizice: câmpul electric de străpungere, banda interzisă, conductivitatea termică și punctul de topire (Figura 1).
 Figura 1: Sunt prezentate avantajele MOSFET-urilor SiC față de Si pe baza a cinci proprietăți fizice. (Sursa imaginii: ROHM Semiconductor)
Figura 1: Sunt prezentate avantajele MOSFET-urilor SiC față de Si pe baza a cinci proprietăți fizice. (Sursa imaginii: ROHM Semiconductor)
Intensitatea câmpului electric de străpungere a SiC este de zece ori mai mare decât cea a Si, ceea ce face posibilă proiectarea de dispozitive cu tensiuni de străpungere mai mari, reducând în același timp grosimea dispozitivului. Banda interzisă mai largă a SiC permite funcționarea dispozitivelor la temperaturi mult mai ridicate. Conductivitatea termică mai mare reduce efortul necesar pentru răcirea dispozitivului, în timp ce punctul de topire mai ridicat mărește intervalul temperaturii de funcționare. În cele din urmă, viteza mai mare de abatere a electronilor saturați din SiC rezultă în frecvențe de comutare mai mari și pierderi mai mici la comutare. Aceste frecvențe de comutare mai mari necesită filtre mai mici și alte componente pasive, reducând și mai mult dimensiunea și greutatea.
Dezvoltarea MOSFET
MOSFET-urile SiC originale foloseau o structură planară în care poarta și canalul dispozitivului se aflau pe suprafața semiconductorului. Dispozitivele planare sunt limitate în ceea ce privește densitatea componentelor, deoarece există o limită până la cât de mult pot fi reduse dimensiunile proiectelor în încercarea de a îmbunătăți randamentul dispozitivului. Utilizarea MOSFET-urilor cu un singur șanț sau cu două șanțuri oferă posibilitatea de a obține densități mai mari ale dispozitivelor (Figura 2).
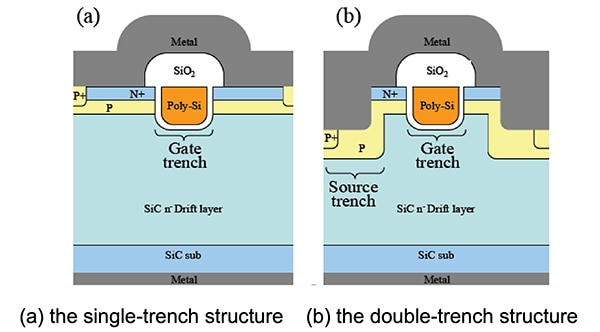 Figura 2: MOSFET-urile tip trench permit obținerea unor densități mai mari ale dispozitivelor prin dispunerea pe verticală a elementelor dispozitivului. (Sursa imaginii: ROHM Semiconductor)
Figura 2: MOSFET-urile tip trench permit obținerea unor densități mai mari ale dispozitivelor prin dispunerea pe verticală a elementelor dispozitivului. (Sursa imaginii: ROHM Semiconductor)
Ca și alte MOSFET-uri, o celulă MOSFET tip trench conține drenă, poartă și sursă, dar este dispusă vertical. Canalul se formează pe verticală, paralel cu șanțul porții, prin intermediul efectului de câmp. Direcția fluxului de curent este verticală, de la sursă la drenă. În comparație cu un dispozitiv planar, care este distribuit pe orizontală și ocupă o mare parte din suprafață, această structură este foarte compactă.
Structura cu un singur șanț utilizează un șanț cu o singură poartă. Dispozitivul cu două șanțuri are atât un șanț de poartă, cât și unul sursă. ROHM Semiconductor a trecut la structura cu două șanțuri pentru cea de a treia generație de MOSFET-uri SiC. Cea de a patra generație a avansat designul cu două șanțuri prin reducerea dimensiunii celulei, reducând și mai mult rezistența în stare activă și capacitatea parazită, ceea ce duce la pierderi de putere mult mai mici și oferă opțiunea de a utiliza dispozitive SiC mai mici pentru proiecte de sisteme mai rentabile.
Scăderea rezistenței în stare activă a unui MOSFET poate compromite capacitatea acestuia de a gestiona scurtcircuitele. Totuși, cea de a patra generație de MOSFET SiC atinge o rezistență mai mică în stare activă, fără a sacrifica timpul de rezistență la scurtcircuit, oferind acestor dispozitive un avantaj semnificativ atunci când vine vorba de obținerea atât a unei eficiențe ridicate, cât și a unei rezistențe puternice la scurtcircuit.
Înțelegerea pierderilor
Pierderile dintr-un convertor în comutație provin din mai multe surse; cele asociate dispozitivelor active includ pierderi la conducție, la comutare și în dioda de substrat (Figura 3).
 Figura 3: Este prezentată o schemă a unui convertor c.c./c.c. de coborâre etichetat pentru a arăta formele de undă de comutare și formele de undă de pierdere asociate. (Sursa imaginii: ROHM Semiconductor)
Figura 3: Este prezentată o schemă a unui convertor c.c./c.c. de coborâre etichetat pentru a arăta formele de undă de comutare și formele de undă de pierdere asociate. (Sursa imaginii: ROHM Semiconductor)
Convertorul de coborâre utilizează un design cu pol de ieșire în contratimp cu un comutator MOSFET de tip high-side (SH) și unul de tip low-side (SL). Comutatoarele sunt acționate în defazaj, astfel încât doar unul dintre ele să conducă la un moment dat. Formele de undă de comandă a porții (VGSH și VGSL) arată treptele de amplitudine datorate intervalelor de încărcare asociate pentru capacitățile parazite ale dispozitivului. Sunt prezentate formele de undă ale tensiunii de la drenă la sursă (VDSH, VDSL) și ale curentului de drenă (IDH, IDL) pentru ambele dispozitive. Atunci când dispozitivul este pornit, VDS este scăzut. Atunci când dispozitivul este oprit, VDS este ridicat. În timpul în care SH este pornit, curentul de drenă crește liniar în timp ce încarcă câmpul magnetic al inductorului. În acest timp, curentul prin rezistența canalului dezvoltă o tensiune pe canal, ceea ce duce la pierderi de conducție (PCOND) care sunt proporționale cu pătratul curentului și cu rezistența în stare activă a canalului. În timpul intervalelor în care dispozitivul își schimbă starea, tensiunea și curentul sunt ambele diferite de zero, iar puterea disipată în dispozitiv este proporțională cu tensiunea, curentul, timpul de tranziție de comutare și frecvența de comutare. Acestea sunt pierderile de comutare.
O situație similară apare atunci când SL este activat. Aici, curentul scade liniar, deoarece energia stocată în inductor asigură curentul de drenă în dispozitivul inferior. Din nou, rezistența canalului disipează energie sub formă de pierderi de conducție. Rețineți că VDSL în dispozitivul inferior este aproape de zero înainte ca curentul să devină diferit de zero, astfel încât nu există pierderi de comutare asociate cu această parte a ciclului.
Pierderea la recuperare (PQrr) este cauzată de recuperarea diodei de substrat a dispozitivelor; pentru simplificare, aceasta este prezentată numai pentru configurația high-side.
Pbody este conducția diodei de substrat a dispozitivelor. Această pierdere este generată de curentul care trece prin dioda de substrat a dispozitivului low-side.
Pierderea totală de putere este suma tuturor acestor componente pentru ambele tranzistoare.
Performanțe îmbunătățite ale celei de a patra generații de MOSFET-uri SiC
O comparație a performanțelor IGBT-urilor Si, precum și a MOSFET-urilor SiC din generația a 3-a și a 4-a, a fost realizată folosind un invertor cu punte completă de 5 kilowați (kW) (Figura 4). În acest circuit cu punte completă, dispozitivele de comutare sunt conectate în paralel pentru o capacitate de curent mai mare. Puntea completă utilizează opt dispozitive în total. Cele opt dispozitive sunt prezentate montate pe radiatorul din imaginea din stânga. Eficiența circuitului a fost evaluată folosind IGBT-ul original și MOSFET-urile din generația a treia și a patra. Invertorul funcționează la o frecvență de comutare de 40 kilohertzi (kHz) cu MOSFET-urile SiC și la 20 kHz cu IGBT.
 Figura 4: Se prezintă un invertor fără ventilator de 5 kW și schema acestuia. Proiectat inițial cu IGBT-uri de siliciu care funcționau la 20 kHz, acest circuit a fost rulat cu MOSFET-uri SiC de generația a 3-a și a 4-a la 40 kHz. S-au comparat performanțele tuturor celor trei tipuri de semiconductori. (Sursa imaginii: ROHM Semiconductor)
Figura 4: Se prezintă un invertor fără ventilator de 5 kW și schema acestuia. Proiectat inițial cu IGBT-uri de siliciu care funcționau la 20 kHz, acest circuit a fost rulat cu MOSFET-uri SiC de generația a 3-a și a 4-a la 40 kHz. S-au comparat performanțele tuturor celor trei tipuri de semiconductori. (Sursa imaginii: ROHM Semiconductor)
Dispozitivul de a treia generație a fost un dispozitiv SCT3030AL de la ROHM Semiconductor cu o tensiune nominală de 650 de volți și o rezistență de canal (RDS(ON)) de 30 de miliohmi (mΩ). MOSFET-ul de generația a patra a fost un SCT4026DEC11 de la ROHM Semiconductor. Tensiunea nominală a dispozitivului de a patra generație a fost mărită la 750 de volți. RDS(ON) este de 26 mΩ, o reducere de 13% care a scăzut ușor pierderile de conducție.
O comparație a pierderilor ambelor MOSFET-uri SiC cu cele ale IGBT-ului original arată îmbunătățirea eficienței (Figura 5).
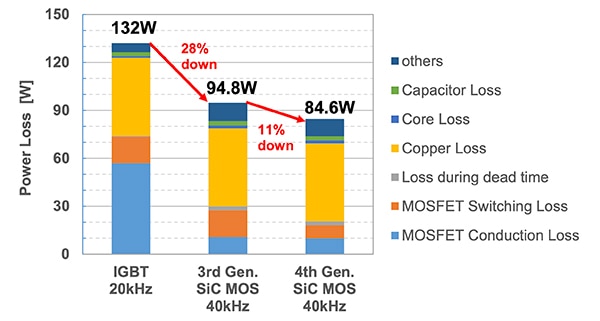 Figura 5: A patra generație de MOSFET-uri SiC a redus semnificativ pierderile în comparație cu IGBT-ul Si original și cu dispozitivul din a treia generație. (Sursa imaginii: ROHM Semiconductor)
Figura 5: A patra generație de MOSFET-uri SiC a redus semnificativ pierderile în comparație cu IGBT-ul Si original și cu dispozitivul din a treia generație. (Sursa imaginii: ROHM Semiconductor)
Dispozitivul din generația a 4-a a redus pierderile de conducție (albastru) de la 10,7 la 9,82 wați comparativ cu dispozitivul din generația a 3-a. O reducere mai semnificativă a fost obținută în cazul pierderilor de comutare (portocaliu), o scădere de la 16,6 la 8,22 wați.
Îmbunătățirile suplimentare aduse dispozitivelor din a patra generație includ capacități îmbunătățite de acționare a porții. A patra generație de MOSFET-uri SiC acceptă comanda cu 15 volți; dispozitivele din a treia generație necesită 18 volți. Acest lucru înseamnă că circuitele proiectate cu dispozitive Si pot utiliza MOSFET-uri din a patra generație ca înlocuitori. În plus, tensiunea de comandă recomandată în timpul opririi este de 0 volți pentru MOSFET-urile SiC din a patra generație. Înainte de produsele din generația a 4-a, tensiunea poartă-sursă avea nevoie de o polarizare negativă în timpul opririi pentru a preveni pornirea automată. Cu toate acestea, în dispozitivele din a patra generație, tensiunea de prag (Vth) este proiectată să fie ridicată pentru a suprima pornirea automată, eliminând necesitatea aplicării polarizării negative.
Soluții din a patra generație
Soluțiile MOSFET SiC din generația a 4-a de la ROHM Semiconductor se împart în două grupe, în funcție de capsula dispozitivului. SCT4026DEC11, despre care s-a discutat, este un MOSFET SiC de 750 volți, 56 amperi (A) (+25 °C)/29 A (+100 °C), 26 mΩ SiC într-o capsulă TO-247N cu trei conductoare. Un exemplu de capsulă alternativă cu patru conductoare este SCT4013DRC15, un dispozitiv de 750 de volți, 105 A (+25 °C)/74 A (+100 °C), 13 mΩ într-o capsulă TO-247-4L cu patru conductori.
Capsula cu patru conductoare adaugă un conductor suplimentar care îmbunătățește viteza de comutare a MOSFET-ului. Capsula convențională TO-247N cu trei pini nu izolează comanda porții de inductanța parazită sursă-conductor din cauza curentului de drenă ridicat. Tensiunea de poartă este aplicată între pinii de poartă și sursă. Tensiunea efectivă a porții la cip este redusă din cauza căderii de tensiune prin inductanța parazită (VL) a terminalului sursei, ceea ce determină reducerea vitezei de comutare (Figura 6).
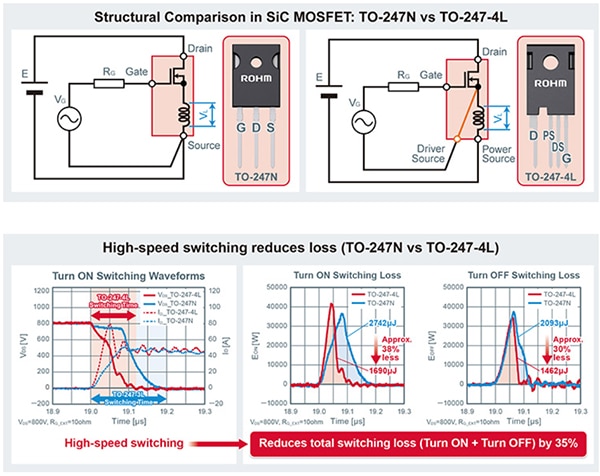 Figura 6: Al patrulea pin de pe TO-247-4L izolează comanda porții de pinii sursei de alimentare folosind un pin de conectare suplimentar într-o conexiune Kelvin. (Sursa imaginii: ROHM Semiconductor)
Figura 6: Al patrulea pin de pe TO-247-4L izolează comanda porții de pinii sursei de alimentare folosind un pin de conectare suplimentar într-o conexiune Kelvin. (Sursa imaginii: ROHM Semiconductor)
Capsula TO-247-4L cu patru pini separă pinii de comandă a porții și pinii sursei de alimentare, conectând comanda porții direct la sursă în interior. Acest lucru minimizează efectele inductanței parazite a pinului sursă. Conectarea directă a comenzii porții la conexiunea sursei interne face posibilă maximizarea vitezei de comutare a MOSFET-urilor SiC, reducând pierderile totale de comutare (activare și dezactivare) cu până la 35% în comparație cu capsulele TO-247N convenționale cu trei pini.
A doua specificație care diferențiază cea de a patra generație de MOSFET-urile SiC este tensiunea nominală. Dispozitivele sunt disponibile cu tensiuni nominale de 750 de volți sau 1200 de volți. Cele două dispozitive discutate până acum au o tensiune nominală de 750 de volți. Pentru aplicații de tensiune mai mare, SCT4062KEC11 este un MOSFET SiC cu canal N de 1200 volți, 62 mΩ, 26 A (+25 °C)/18 A (+100 °C) într-o capsulă TO-247N cu trei conductoare, în timp ce SCT4036KRC15 este un MOSFET cu canal N de 1200 volți, 36 mΩ, 43 A (+25 °C)/30 A (+100 °C) într-o capsulă TO-247-4L cu patru conductoare. În total, în prezent sunt disponibile zece MOSFET-uri SiC de generația a 4-a, cu valori nominale de curent de la 26 A la 105 A la +25 °C. Acestea au valori RDS(ON) cuprinse între 13 și 62 mΩ.
Aplicații ale vehiculelor electrice
Specificațiile celei de a patra generații de MOSFET SiC sunt bine adaptate la aplicațiile vehiculelor electrice. Un exemplu în acest sens îl constituie vehiculele electrice cu baterie (BEV) cu tensiuni de 400 sau 800 de volți (Figura 7).
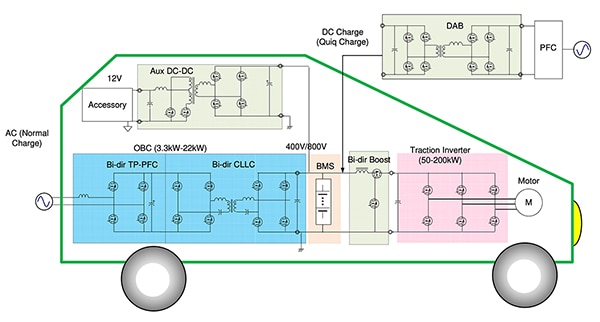 Figura 7: Aplicații tipice ale MOSFET-ului SiC de generația a 4-a în cadrul unui BEV și accesoriile externe asociate. (Sursa imaginii: ROHM Semiconductor)
Figura 7: Aplicații tipice ale MOSFET-ului SiC de generația a 4-a în cadrul unui BEV și accesoriile externe asociate. (Sursa imaginii: ROHM Semiconductor)
Figura 7 prezintă o schemă bloc a unui BEV cu o tensiune a bateriei de 400 sau 800 de volți, care suportă atât încărcarea bidirecțională, cât și cea rapidă. Încărcătorul de la bord (OBC) include circuite de corecție a factorului de putere (PFC) cu pol de ieșire în contratimp și un convertor rezonant CLLC (condensator, inductor, inductor, condensator) bidirecțional, cu punte completă. Încărcătorul extern „Quiq” de încărcare c.c. asigură încărcarea directă a bateriei. Bateria acționează invertorul de tracțiune, care convertește curentul continuu în curent alternativ trifazat pentru a acționa motorul. Toate aceste circuite utilizează MOSFET-uri în diferite configurații de circuit pentru a gestiona nivelurile de putere necesare. MOSFET-urile SiC din a patra generație sunt importante deoarece reduc dimensiunea fizică a circuitului și cresc tensiunea nominală, reducând în același timp pierderile și costurile.
Concluzie
Pentru proiectanții de aplicații de înaltă tensiune și de mare putere, inclusiv pentru vehiculele electrice, centrele de date și stațiile de bază, MOSFET-urile SiC din a patra generație sunt dispozitive cheie de comutare a puterii. După cum s-a arătat, acestea utilizează o structură unică pentru a îmbunătăți considerabil eficiența conversiei de putere prin reducerea pierderilor, reducând în același timp amprenta și costul.
Lectură recomandată:

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.







