Cum să aplicați MOSFET-urile SiC de a treia generație în proiectele de putere pentru performanță și eficiență mai mari
Contributed By DigiKey's North American Editors
2022-11-02
Există un efort neîncetat pentru eficiență mai mare, dimensiuni mai mici și performanțe îmbunătățite în aplicațiile de putere, cum ar fi driverele motoarelor industriale, invertoarele/convertoarele c.a./c.c. și c.c./c.c., încărcătoarele de baterii și sistemele de stocare a energiei. Aceste cerințe agresive de performanță au depășit capacitățile MOSFET-urilor din siliciu (Si) și au dus la apariția unor arhitecturi de tranzistori mai noi bazate pe carbură de siliciu (SiC).
În timp ce aceste dispozitive mai noi ofereau beneficii semnificative în ceea ce privește parametrii cheie de performanță, proiectanții au fost înțelepți să fie atenți la dispozitivele SiC din prima generație din cauza diferitelor limitări și incertitudini legate de aplicații. Dispozitivele din a doua generație au adus specificații îmbunătățite, împreună cu o mai bună înțelegere a subtilităților dispozitivelor. Pe măsură ce performanța MOSFET-urilor SiC a crescut și presiunile legate de timpul de lansare pe piață s-au intensificat, proiectanții au folosit aceste dispozitive mai noi pentru a îndeplini obiectivele produsului. Mai recent, dispozitivele din a treia generație demonstrează maturitatea dispozitivelor de putere pe bază de SiC. Aceste dispozitive oferă utilizatorilor îmbunătățiri ale parametrilor cheie, bazându-se în același timp pe experiența de proiectare și pe expertiza conexă a generațiilor anterioare.
Acest articol compară Si cu SiC, apoi discută despre dezvoltarea și migrarea către cea de-a treia generație de MOSFET-uri SiC. În continuare, prezintă exemple reale de la Toshiba Semiconductor and Storage Corp. (Toshiba) pentru a arăta modul în care aceste dispozitive îi pot ajuta pe proiectanți să realizeze progrese semnificative în proiectarea sistemelor de alimentare.
Siliciu versus SiC
În ultimele decenii, MOSFET-ul pe bază de siliciu a transformat proiectarea sistemelor de alimentare, de la surse de alimentare de bază și invertoare până la acționări de motoare. Împreună cu tranzistorul bipolar cu poartă izolată (IGBT) – un semiconductor similar din punct de vedere funcțional, dar cu o construcție și atribute foarte diferite – MOSFET-ul Si MOSFET cu comutație optimizată a permis trecerea de la conversia și gestionarea tradițională și ineficientă a energiei, bazată pe topologii liniare, la o abordare mult mai eficientă și mai compactă, care utilizează controlul prin comutație.
Majoritatea acestor modele utilizează o formă de modulare a impulsurilor în lățime (PWM) pentru a furniza și a menține tensiunea, curentul sau puterea dorită într-un aranjament de reacție în buclă închisă. Pe măsură ce utilizarea MOSFET-urilor din siliciu a crescut, au crescut și cerințele impuse acestora. În plus, noile obiective de eficiență (multe dintre ele bazate pe mandate de reglementare), piețele pentru vehicule electrice și controlul mai inteligent al motoarelor, conversia de putere pentru energie regenerabilă și sistemele de stocare a energiei asociate au determinat aceste MOSFET-uri să facă mai multe și mai bine.
Drept urmare, o cantitate considerabilă din efortul de cercetare și dezvoltare a îmbunătățit performanța MOSFET-urilor pe bază de siliciu, dar cercetătorii au realizat că acest efort a ajuns la punctul în care randamentul scade. Din fericire, ei aveau o alternativă, în teorie, bazată pe dispozitive de comutare a puterii care foloseau SiC ca și substrat în loc de siliciu.
De ce să folosiți SiC?
Din diverse motive legate de noțiuni avansate de fizică, SiC are trei caracteristici electrice majore care diferă semnificativ de siliciu și fiecare dintre acestea aduce avantaje operaționale; există și alte diferențe mai subtile (Figura 1).
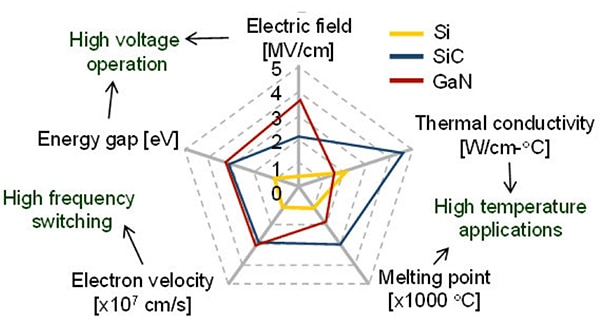 Figura 1: comparație aproximativă între proprietățile materiale cheie ale SiC față de Si și materialele solide din nitrură de galiu (GaN). (Sursa imaginii: Researchgate)
Figura 1: comparație aproximativă între proprietățile materiale cheie ale SiC față de Si și materialele solide din nitrură de galiu (GaN). (Sursa imaginii: Researchgate)
Cele trei caracteristici principale sunt:
- Tensiune de străpungere critică mai mare a câmpului electric, de aproximativ 2,8 megavolți/centimetru (MV/cm) față de 0,3 MV/cm, astfel că funcționarea la o tensiune nominală dată este posibilă cu un strat mult mai subțire, reducând considerabil rezistența la pornire (RDS(on)) drenă-sursă.
- Conductivitate termică mai mare, ceea ce permite o densitate mai mare de curent pe o suprafață de secțiune transversală.
- Bandă interzisă mai amplă (diferența de energie în electroni-volți dintre partea superioară a benzii de valență și partea inferioară a benzii de conducție în semiconductori și izolatoare), ceea ce duce la un curent de scurgere mai mic la temperaturi ridicate. Din acest motiv, diodele SiC și tranzistoarele cu efect de câmp (FET) sunt adesea denumite dispozitive cu bandă interzisă largă (WBG).
Drept urmare, dispozitivele pe bază de SiC pot bloca tensiuni de până la zece ori mai mari decât structurile doar cu siliciu, pot comuta de aproximativ zece ori mai repede și au un RDS(on) de jumătate sau mai puțin la 25 °C, utilizând în același timp aceeași suprafață a matriței (toate valorile sunt, desigur, aproximative). De asemenea, pierderile legate de comutarea la închidere a dispozitivelor SiC sunt mai mici, deoarece nu există un curent de coadă dăunător. În același timp, capacitatea lor de a funcționa la temperaturi mult mai ridicate, de aproximativ 200 °C, față de 125 °C, ușurează problemele de proiectare și gestionare termică.
Datorită atributelor și progreselor lor în ceea ce privește performanța, dispozitivele SiC au ocupat acum un loc proeminent în matricea aplicațiilor de putere vs. viteză, alăturându-se IGBT-urilor, MOSFET-urilor de siliciu și dispozitivelor GaN (Figura 2).
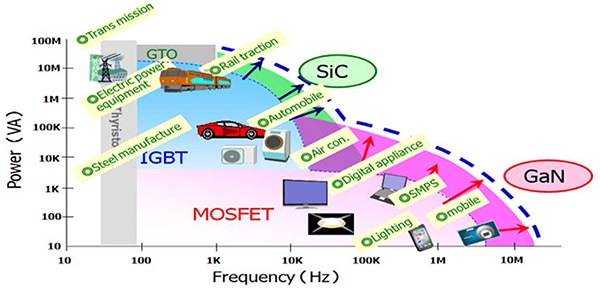 Figura 2: atributele de performanță ale MOSFET-urilor SiC le fac potrivite pentru o gamă largă de aplicații care cuprind o gamă largă de puteri și frecvențe nominale. (Sursa imaginii: Toshiba)
Figura 2: atributele de performanță ale MOSFET-urilor SiC le fac potrivite pentru o gamă largă de aplicații care cuprind o gamă largă de puteri și frecvențe nominale. (Sursa imaginii: Toshiba)
Drumul de la știința materialelor SiC și fizica dispozitivelor de la baza SiC la MOSFET-urile SiC comerciale nu a fost rapid sau ușor (Figura 3). După eforturi extinse de cercetare și producție, primele dispozitive pe bază de SiC – diodele Schottky – au fost introduse în 2001. În cele două decenii care au urmat, industria a dezvoltat și a lansat volume de producție pentru prima, a doua și a treia generație de MOSFET-uri SiC. Fiecare generație oferă îmbunătățiri specifice în ceea ce privește anumiți parametrii, pe lângă câteva compromisuri oarecum diferite.
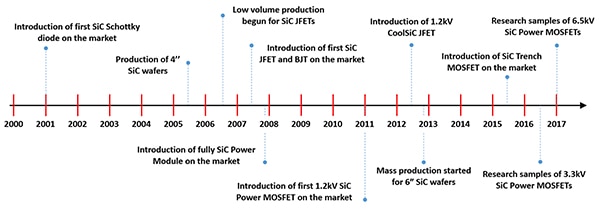 Figura 3: povestea dispozitivelor comerciale pe bază de SiC începe cu primele diode Schottky SiC comerciale, care au apărut în 2001. (Sursa imaginii: IEEE Transactions on Industrial Electronics, 2017)
Figura 3: povestea dispozitivelor comerciale pe bază de SiC începe cu primele diode Schottky SiC comerciale, care au apărut în 2001. (Sursa imaginii: IEEE Transactions on Industrial Electronics, 2017)
Rețineți că este important ca terminologia să fie clară: la fel ca predecesorii lor pe bază de siliciu, FET-urile pe bază de SiC sunt MOSFET-uri. În sens larg, structurile lor fizice interne sunt similare și ambele sunt dispozitive cu trei terminale, cu conexiuni de sursă, drenă și poartă. Diferența este cea indicată de numele lor: FET-urile pe bază de SiC utilizează SiC ca material de bază și nu doar siliciu.
Începeți cu prima și a doua generație
Există mulți parametri care caracterizează performanța unui dispozitiv de comutare. Printre numeroșii parametri statici se numără tensiunea maximă de funcționare și valoarea nominală maximă a curentului, împreună cu două cifre statice de merit (FoM): RDS(on) și temperatura maximă de funcționare, care sunt legate de capacitatea de gestionare a puterii pentru o anumită dimensiune a matriței și un anumit pachet.
Ca dispozitive de comutare, parametrii dinamici sunt, de asemenea, esențiali, deoarece sunt necesari pentru a evalua pierderile de comutare. Cel mai citat FoM dinamic este produsul dintre RDS(on) și sarcina de poartă, RDS(on) × Qg, în timp ce unul care devine tot mai important este sarcina de recuperare inversă, Qrr. Dimensiunea și capacitățile driverului de poartă necesare pentru a furniza și a absorbi în mod corespunzător curentul către dispozitivul de comutare – și pentru a face acest lucru fără supraîncărcare, oscilații pendulare sau alte distorsiuni – sunt determinate în primul rând de aceste FoM-uri.
Utilizarea și creșterea pe piață a dispozitivelor SiC din prima generație a fost împiedicată de problemele de fiabilitate. Una dintre acestea implică diodele PN, care sunt poziționate între sursa de alimentare și drena unui MOSFET de putere. Tensiunea aplicată diodei PN o energizează, ceea ce duce la o schimbare a rezistenței de pornire care degradează fiabilitatea dispozitivului.
A doua generație de la Toshiba a modificat structura de bază a dispozitivului SiC prin utilizarea unei diode cu barieră Schottky (SBD) încorporată în MOSFET pentru a rezolva în mare parte această problemă (Figura 4). Acest lucru a îmbunătățit fiabilitatea cu mai mult de un ordin de magnitudine. Noua structură a împiedicat punerea sub tensiune a diodei PN prin poziționarea SBD în paralel cu dioda PN în interiorul celulei. Curentul circulă prin SBD încorporat deoarece tensiunea sa în stare activă este mai mică decât cea a diodei PN, suprimând astfel unele modificări ale rezistenței la pornire și degradarea fiabilității MOSFET-ului.
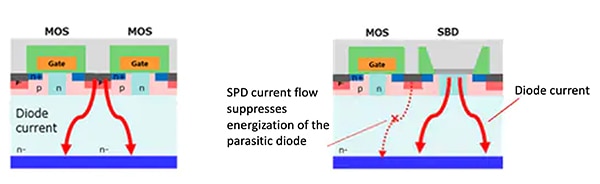 Figura 4: spre deosebire de MOSFET-ul SiC tipic fără o diodă cu barieră Schottky internă (SBD) (stânga), cel cu aceasta (dreapta) poate minimiza punerea sub tensiune a diodei PN parazite. (Sursa imaginii: Toshiba)
Figura 4: spre deosebire de MOSFET-ul SiC tipic fără o diodă cu barieră Schottky internă (SBD) (stânga), cel cu aceasta (dreapta) poate minimiza punerea sub tensiune a diodei PN parazite. (Sursa imaginii: Toshiba)
MOSFET-urile cu SBD-uri încorporate erau deja utilizate, dar numai în produse de înaltă tensiune – cum ar fi dispozitivele de 3,3 kilovolți (kV) – deoarece SBD-ul încorporat făcea ca rezistența de pornire să crească până la un nivel pe care numai produsele de înaltă tensiune îl puteau tolera. Toshiba a ajustat diferiți parametri ai dispozitivului și a descoperit că raportul dintre suprafața SBD într-un MOSFET este esențial pentru suprimarea rezistenței crescute la pornire. Prin optimizarea raportului SBD, Toshiba a conceput un MOSFET SiC de clasă 1,2 kV cu o îmbunătățire remarcabilă a fiabilității.
Cu toate acestea, ca în cazul multor îmbunătățiri, au existat compromisuri. Deși noua structură a dispozitivului a îmbunătățit semnificativ fiabilitatea, aceasta a avut și un efect negativ asupra a două FoM-uri. A crescut RDS(on) nominal, precum și RDS(on) × Qg, reducând performanța MOSFET-ului. Pentru a compensa și a reduce rezistența de pornire, MOSFET-urile SiC din a doua generație au crescut suprafața matriței, dar acest lucru a crescut costurile.
A treia generație demonstrează adevărata maturitate
Recunoscând această preocupare, Toshiba a dezvoltat o a treia generație de dispozitive MOSFET SiC, numită familia TWXXXN65C/TWXXXN120C. Aceste dispozitive au optimizat structura stratului de răspândire a curentului pentru a reduce dimensiunea celulei și pentru a oferi o tensiune nominală mai mare, o comutare mai rapidă și o rezistență la pornire mai mică.
Rezistența la pornire este redusă parțial prin reducerea rezistenței de împrăștiere (Rspread). Curentul SBD crește prin injectarea de azot în partea inferioară a regiunii de difuzie de tip P (P-well) a MOSFET-ului SiC. De asemenea, Toshiba a redus regiunea JFET și a injectat azot pentru a reduce capacitatea de reacție și rezistența JFET. Drept urmare, capacitatea de reacție a fost redusă fără a crește rezistența la pornire. Funcționarea stabilă și fără fluctuații a rezistenței la pornire, a fost, de asemenea, obținută prin poziționarea optimizată a SBD-ului.
În prezent, familia este alcătuită din MOSFET-uri SiC de 650 și 1.200 de volți proiectate pentru aplicații industriale de mare putere, cum ar fi surse de alimentare c.a./c.c. de 400 și 800 de volți, invertoare fotovoltaice (PV) și convertoare bidirecționale c.c./c.c. pentru surse de alimentare neîntreruptibile (UPS). Atât MOSFET-urile SiC de 650 de volți, cât și cele de 1.200 de volți, sunt oferite în capsula TO-247 cu trei conductoare, standard în industrie (Figura 5).
 Figura 5: găzduite într-o capsulă standard TO-247, MOSFET-urile SiC Toshiba de a treia generație, de 650 și 1200 de volți, sunt potrivite pentru o gamă largă de aplicații de conversie, control și gestionare a energiei. (Sursa imaginii: Toshiba)
Figura 5: găzduite într-o capsulă standard TO-247, MOSFET-urile SiC Toshiba de a treia generație, de 650 și 1200 de volți, sunt potrivite pentru o gamă largă de aplicații de conversie, control și gestionare a energiei. (Sursa imaginii: Toshiba)
În aceste MOSFET-uri SiC din a treia generație, RDS(on) × Qg FoM este redus cu 80% comparativ cu dispozitivele Toshiba din a doua generație – o scădere semnificativă – în timp ce pierderile la comutare sunt reduse cu aproximativ 20%. De asemenea, tehnologia încorporată a diodei cu barieră Schottky oferă o tensiune directă (VF) ultra-joasă.
Există și alte subtilități de proiectare asociate cu MOSFET-urile. Luați VGSS ca exemplu. VGSS este tensiunea maximă care poate fi aplicată între poartă și sursă în timp ce drena și sursa sunt scurtcircuitate. Pentru dispozitivele SiC din a treia generație, intervalul VGSS este cuprins între 10 și 25 de volți, valoarea recomandată fiind de 18 volți. Valorile nominale ample ale VGSS ajută la facilitarea proiectării, îmbunătățind în același timp fiabilitatea acesteia.
În plus, rezistența scăzută și o tensiune de prag de poartă mai mare (VGS(th)) – tensiunea la care canalul MOSFET începe să conducă – ajută la prevenirea defecțiunilor, cum ar fi pornirea accidentală din cauza vârfurilor, a erorilor și a supraîncărcărilor. Această tensiune variază între 3,0 și 5,0 volți, contribuind la asigurarea unei performanțe de comutare previzibile cu abatere minimă, permițând în același timp o proiectare simplă a driverului de poartă.
O privire mai atentă asupra MOSFET-urilor SiC de a treia generație, de 650 și 1200 de volți și 1200 de volți
O privire asupra a două dispozitive aflate la capetele opuse ale spectrului familiei, cele de 650 de volți și cele de 1200 de volți, arată amploarea capacităților acestora. Pachetul fizic, schema de conexiuni și simbolul schematic pentru toate acestea este același (Figura 6), dar particularitățile diferă.
 Figura 6: toți membrii familiei de MOSFET-uri SiC de a treia generație de la Toshiba au aceeași dispunere fizică și același simbol schematic; observați dioda integrală cu barieră Schottky în simbol. (Sursa imaginii: Toshiba)
Figura 6: toți membrii familiei de MOSFET-uri SiC de a treia generație de la Toshiba au aceeași dispunere fizică și același simbol schematic; observați dioda integrală cu barieră Schottky în simbol. (Sursa imaginii: Toshiba)
Un dispozitiv de 650 de volți este TW015N65C, un dispozitiv cu canal N cu o putere nominală de 100 de amperi (A) și 342 de wați. Valorile tipice ale specificațiilor sale reprezintă o capacitate de intrare (CISS) de 4.850 picofarazi (pF), o sarcină de intrare cu poartă redusă (Qg) de 128 nanocoulombi (nC) și un RDS(on) nominal de numai 15 miliohmi (mΩ).
Împreună cu tabelele cu cifre minime, tipice și maxime pentru parametrii statici și dinamici, fișa tehnică are grafice care arată performanța parametrilor critici în funcție de factori precum temperatura, curentul de dren și tensiunea poartă-sursă (VGS). De exemplu, valoarea RDS(on) în funcție de temperatură, curentul de dren (ID) și tensiunea poartă-sursă VGS sunt prezentate în Figura 7.
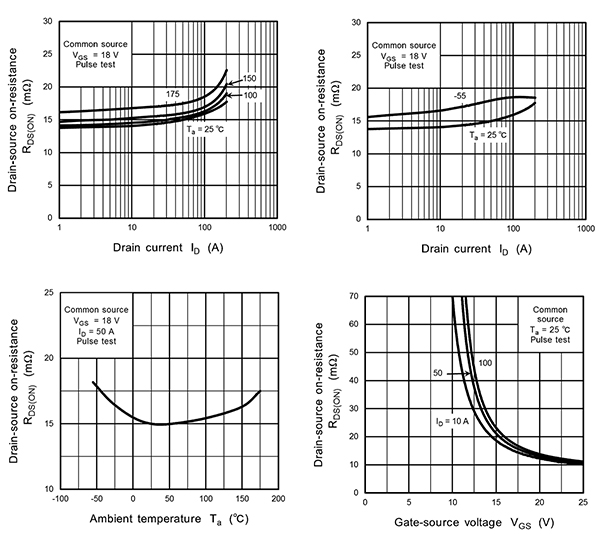 Figura 7: se prezintă grafice care caracterizează rezistența la pornire pentru TWO15N65C din diferite perspective, inclusiv curentul de dren, temperatura ambiantă și VGS. (Sursa imaginii: Toshiba)
Figura 7: se prezintă grafice care caracterizează rezistența la pornire pentru TWO15N65C din diferite perspective, inclusiv curentul de dren, temperatura ambiantă și VGS. (Sursa imaginii: Toshiba)
Același set de specificații și grafice sunt prezentate în Figura 8 pentru dispozitivele de 1200 de volți, cum ar fi TW140N120C, un dispozitiv cu canal N de 20 A, 107 wați. Acest MOSFET SiC are un CISS scăzut, de 6000 pF, o sarcină de intrare la poartă (Qg) de 158 nanocoulombi (nC) și un RDS(on) de 140 mΩ.
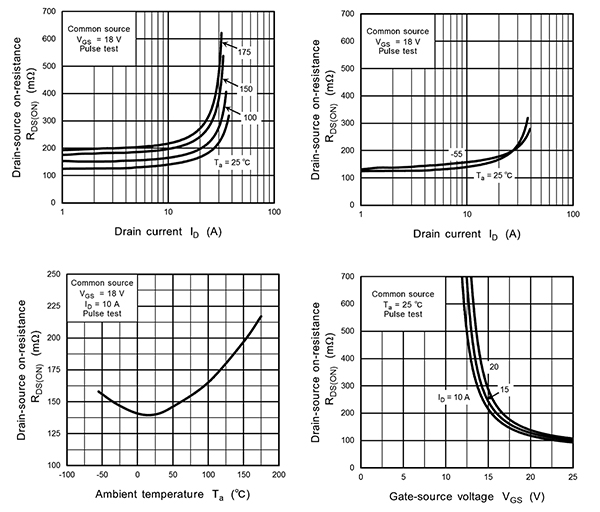 Figura 8: graficele de caracterizare a rezistenței la pornire pentru TW140N120C. (Sursa imaginii: Toshiba)
Figura 8: graficele de caracterizare a rezistenței la pornire pentru TW140N120C. (Sursa imaginii: Toshiba)
Cele zece MOSFET-uri SiC Toshiba din a treia generație disponibile includ cinci dispozitive de 650 de volți și cinci dispozitive de 1200 de volți. La 25 °C, acestea au următoarele valori nominale de rezistență la pornire, curent și putere:
650 de volți:
- 15 mΩ, 100 A, 342 wați (TWO15N65C)
- 27 mΩ, 58 A, 156 wați
- 48 mΩ, 40 A, 132 wați
- 83 mΩ, 30 A, 111 wați
- 107 mΩ, 20 A, 70 wați
1200 de volți:
- 15 mΩ, 100 A, 431 wați
- 30 mΩ, 60 A, 249 wați
- 45 mΩ, 40 A, 182 wați
- 60 mΩ, 36 A, 170 wați
- 140 mΩ, 20 A, 107 wați (TW140N120C)
Concluzie
MOSFET-urile cu carbură de siliciu oferă o îmbunătățire semnificativă a parametrilor critici de comutare, în comparație cu dispozitivele numai din siliciu. Comparativ cu generațiile anterioare, componentele SiC din a treia generație oferă specificații și FoM-uri îmbunătățite, fiabilitate sporită, o mai bună caracterizare a cerințelor de comandă a porții și o mai bună înțelegere a subtilităților inevitabile de proiectare. Prin utilizarea acestor MOSFET-uri SiC, proiectanții de sisteme de alimentare au la dispoziție o resursă de bază suplimentară pe care o pot folosi pentru a obține o eficiență mai bună, dimensiuni mai mici și performanțe generale îmbunătățite.

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.





